Inspektion

Mikroskopische Inspektion:
- Partikel, Kratzer, Strukturdefekte, Vias, Bondpads
- Stepperdefokussierung, Homogenitätsprobleme
- Kanteninspektion (Waferkante wird in dem Bildfeld angepassten Schritten kreisförmig entlang gefahren)
- Framed Waferinspektion
- Inspektion nach Wafer sägen
- Chipping, Ausbrüche, Risse, Delamination
Defekt Review

Mikroskopisches Review:
- Optisches Review mit Defektklassifikation auf Basis importierter Daten eines Defectscanning-Systems (z.B. KLARF-Dateien)
- Umfangreiche Sortiermöglichkeit
- Darstellung der importierten Defektinformationen in einer zoombaren Übersichtsmap
- Schnelle Positioniermöglichkeit zu ausgewählten Defekten auch bei höchster Vergrößerung
- Automatische Bildspeicherung der ausgewählten Defekte ggf. mit mehreren Kontrastverfahren und Fokusebenen
Infrarotmikroskopie

Infrarotmikroskopie (near infrared microscopy):
- Durchlicht-Inspektion (durch Silizium-Wafer-Inspektion)
- NIR Auflicht-Inspektion
- NIR Polarisationsmikroskopie
- Inspektion und Vermessung von vergrabenen Layern
- Hohlrauminspektion
- Membraninspektion
Dünnschichtmesstechnik

Schichtdickenmessung (Thin Film Metrology) für optisch transparente Schichten von 50 nm bis 20 µm.
Overlay-Messung

Die optische Overlay- und Strukturbreitenmessung auf Basis von Lichtmikroskopen ist als berührungsloses und schnelles Messverfahren bewährt.
Die extreme Präzision der Messergebnisse ist auf leistungsfähige Algorithmen und die perfekt abgestimmte Kombination von Mikroskop, Kamera und Software zurückzuführen.
Mit unserer MCS Systemsoftware ist nun auch eine Kombination verschiedener Aufgabenstellungen wie z.B. CD und Schichtdickenmessung oder automatische Inspektion in einem gemischten Prozess möglich.
Programmierte Messpositionen werden exakt angefahren, neue Messkoordinaten können durch Teaching oder Import schnell gelernt werden.
Strukturbreitenmessung / CD

Die optische Overlay- und Strukturbreitenmessung auf Basis von Lichtmikroskopen ist ein bewährtes berührungsloses und schnelles Messverfahren.
Die extreme Präzision der Messergebnisse ist auf leistungsfähige Algorithmen und die perfekt abgestimmte Kombination von Mikroskop, Kamera und Software zurückzuführen.
Mit unserer MCS Systemsoftware ist nun auch eine Kombination verschiedener Aufgabenstellungen wie z.B. CD und Schichtdickenmessung oder automatische Inspektion in einem gemischten Prozess möglich.
Programmierte Messpositionen werden exakt angefahren, neue Messkoordinaten können durch Teaching oder Import schnell gelernt werden.
Die programmierten Messstrukturen werden mittels Bildalignment exakt positioniert. Eine hochauflösende digitale CCD Kamera nimmt Bilder auf, deren Grauwert-Intensitätsprofile für die Subpixelalgorithmen verwendet werden.
Der Laser-Autofokus sorgt für die bedienerunabhängige reproduzierbare Fokusierung.
Oberflächenmesstechnik

Konfokale Mikroskopausrüstung und Weisslichtinterferometrie auf Basis INM200, oder DM8000 mit Hardware & Software zur Vermessung der Topografie und zum Export der 3D Daten. Auch als Upgrade in Kombination mit Inspektion, CD oder Schichtdickenmessung erhältlich.
Typische Aufgaben in der Qualitätssicherung und in der Forschung sind die Charakterisierung von Oberflächen verschiedener Rauheiten (Waferstrukturen, Spiegel, Glas, Metalle), die Bestimmung von Stufenhöhen und die präzise Messung von gekrümmten Oberflächen, wie z.B. Mikrolinsen. Die in der Software enthaltenen effizienten, robusten und hochgenauen Auswertealgorithmen sind Ergebnis umfangreicher Forschungstätigkeit.
Den Messungen liegt das Interferometrie Verfahren zugrunde. Dies stützt sich auf die mögliche Überlagerung von räumlich und zeitlich kohärenten Lichtwellen. Dabei werden die Strahlen der Beleuchtungseinrichtung mittels Strahlteiler aufgeteilt. Ein Teil des Lichtes gelangt zur Objektoberfläche, der andere zu einem Referenzspiegel und von dort zurück reflektiert. Im Unterschied zu vielen anderen Verfahren wird das Bild nicht punktförmig oder zeilenweise gerastert. Die Bildaufnahme geht sekundenschnell (es wird ein Stack von kompletten Kamera-Frames eingezogen) und die Verarbeitung der Messpunkte erfolgt massiv parallel durch Nutzung vieler Grafikprozessoren CUDA. So können Höheninformationen großflächig und in sehr kurzer Zeit gewonnen werden.
Multi-Sensor Systeme flex Wafer
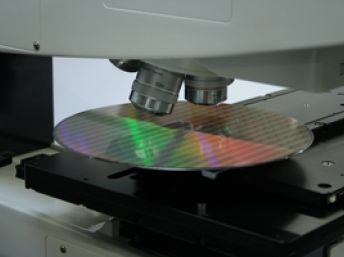
Makro- und Mikroinspektion, Overlay, Strukturbreiten, Schichtdicken und Infrarotmikroskopie - Alles auf einer vollautomatischen Anlage mit flexiblem Robot-Waferhandling für Batchbetrieb, auch mit unterschiedlichen Waferdurchmessern und ggfs. Edge-Handling.
Kontaktieren Sie uns - Sie werden überrascht sein, welche Lösungen wir bereits realisiert haben.
